


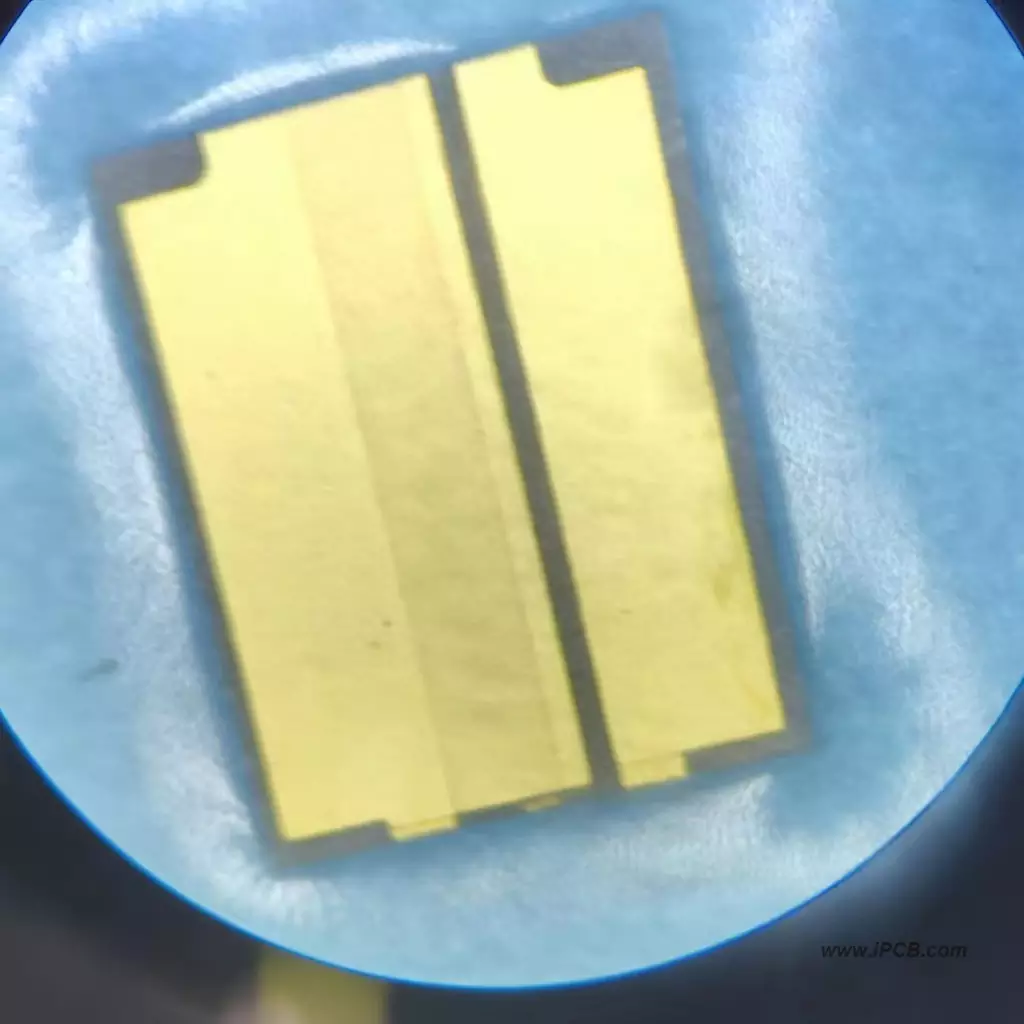
AuSnラジエータは表面にAuSn半田層が塗布された基板で、光電子工業に広く応用されている。AuSn薄膜ヒートシンク接合領域の半田厚は正確に制御でき、追加のプリフォームパッドや半田ペーストを使用する必要がなく、直接半田付けすることができます。
ラジエータとは、大気や地球など、それに伝わる熱エネルギーの大きさによって温度が変化しない物体のことです。一般的に、ヒートシンクにはいくつかの分類があります。
工業では、電子チップを冷却するためのマイクロヒートシンクを指します。航空宇宙工学において、液体窒素壁板の内面に黒色塗料を塗布することによって空間的に冷たい黒色環境をシミュレートする装置を指します。現在、LED照明パッケージでは、LED発光時に発生する熱が高いため、熱伝導性の高い銅柱を用いてパッケージ外部に熱を導きます。このLED銅柱は放熱器とも呼ばれています。LD(レーザダイオード)も大量の熱を発生し、放熱を助け、動作温度を安定させるために放熱器に取り付ける必要があります。
1.AuSn半田層の厚さは2μm〜10μmの範囲である物理蒸着法。
2.合金膜の成分が正確です。
3.完成品とAuSnコーティング加工サービスを提供することができます。
4.薄膜回路技術のリソグラフィ、コーティング及びスライスの全プロセス能力を備える。
5.AuSn合金は融点が低く、ろう付け温度が適度であり、ろう付け過程全体を大幅に短縮した。AuSn合金セラミック回路基板はAuSn半田を使用し、半田付け温度はその融点より20〜30℃(約300〜310℃)だけ高い。AuSn合金は共晶であるため、合金は溶融が速く、凝固が速い。高い安定性が要求される部品の組み立ては、一般的にAuSn合金に適している。
6.250〜260℃の高温での高強度気密性要求を満たすことができる。
7.湿潤性が良く、良好な湿潤性があり、鉛錫半田はメッキ層に腐食がない。AuSn合金の成分は金めっき層の成分と似ているため、非常に薄いコーティングは拡散による浸漬度が非常に低く、銀のような移動現象はない。
8.低粘度-大きな隙間を充填し、安定性を維持し、流動性がない。
9.その半田は高い耐食性、高い耐クリープ性及び良好な熱伝導性と導電性を有するため、良好な熱伝導率を有し、熱伝導率は57 W/mKである。
10.鉛フリーで環境に優しい。

図1 AuSn基板
AuSnラジエータの欠点
1.価格が高く、性能が脆く、伸びが低く、加工が難しい。
2.融点が高いため、低融点半田と同時に半田付けできない。
3.チップが300℃以上の短期温度に耐えられる場合にのみ適用する。
4.メッキが多すぎ、パッドが薄く、溶接時間が長くなると、はんだ中の金の拡散が増加し、融点が高くなる。
AuSnラジエータ仕様パラメータ
はんだ層成分:Au 70 Sn 30、Au 75 Sn 25。
半田層の厚さ:2-10μm±20%。
基板材料:窒化アルミニウム、酸化アルミニウム、タングステン銅、モリブデン銅、石英、シリコンなど。
金属化層:Ti/Pt/Au、Ti/Ni/Au、Cu/Ni/Au、Cu/Ni/Pd/Auなど。金属化層は顧客の要求に応じてカスタマイズすることができる。
AuSn放熱器の応用
1.レーザダイオード:AuSn合金は光電子レーザパッケージに重要な応用がある。今後5年間、AuSn合金は光通信とフォトンコンピュータの発展を促進する重要なパッケージ材料になるだろう。
2.大電力LEDへの応用:チップパッケージによる大電力LEDの放熱能力の向上はLEDデバイスパッケージと応用設計が解決しなければならない核心問題、すなわちAuSnによるゲルマニウムウエハとヒ化ガリウムウエハとの界面を結合した超音波画像である。
3.IC及びパワー半導体装置の応用において、AuSn 20合金はんだは、280〜360℃の間の高融点鉛基合金の融点に代わる唯一のはんだである。AuGeとAuSiは主にチップと回路基板間の接続に用いられるが、AuSn 20半田はチップと回路基板間の接続に加えて、様々な高信頼性回路の気密パッケージに広く用いることができる。
4.薄膜集積回路用の電気めっきAuSn合金パッド。セラミックス基板上のAuSn放熱器技術の利点は明らかである。AuSn合金めっき法により形成されたAu 80/Sn 20半田は、マイクロ電子、光電子、半導体発光、MEMSなどの分野で広い応用の見通しがあり、生産と応用に投入されている。

図2 AuSn基板
需要の高まりに伴い、レーザーチップの小型化の傾向が顕著になっています。しかし、小チップの放熱性は低く、動作と非動作放熱器の温度差は小さく、熱整合要求は低い。窒化アルミニウム材料は、チップに接続された基板として使用することができます。電子パッケージの分野では、ヒートシンクは主に電子チップを冷却するためのマイクロヒートシンクを指し、コア部品の1つです。従来のヒートシンク製品は、組み立て効率、信頼性、性能などの面で大きな向上空間を持っています。セラミックス放熱器は大出力半導体レーザチップの結合需要を満たすことができ、光通信、大出力LEDパッケージ、半導体レーザと光ファイバレーザポンプ源の製造などの分野で広い応用見通しを持っています。
製品名: AuSn Heat Sink Substrate
層数:2層
基板の厚さ:0.25mm
銅箔の厚さ:18-35um
はんだ層の組成: Au70Sn30, Au75Sn25
基板材料:窒化アルミニウム、アルミナ、タングステン銅、モリブデン銅、石英、シリコン
金属化層:Ti/Pt/Au、Ti/Ni/Au、Cu/Ni/Au及びCu/Ni/Pd/Au
お客様の要件に合わせてメタライズ層をカスタマイズ
応用:大電力チップ、大電力レーザ
PCB技術の問題については、IPCB知識サポートチームは、すべてのステップをお手伝いしてここにある。また、ここでPCB引用を要求することもできます。お問い合わせメール sales@ipcb.jp
我々は非常に迅速に対応します。